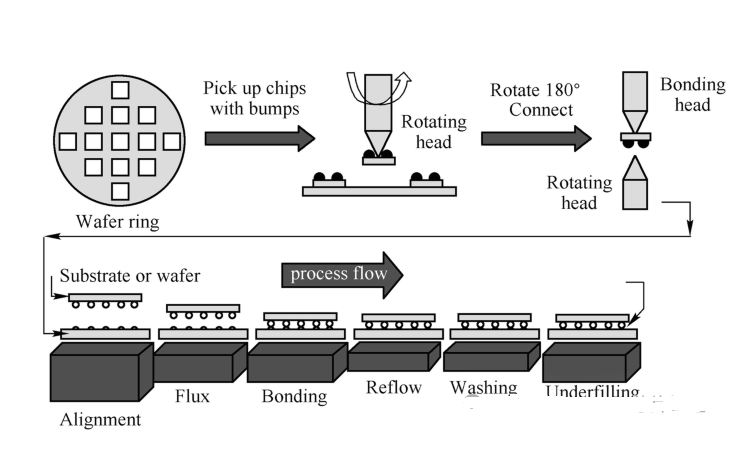
Jarrai dezagun ’ txipak jartzeari buruzko prozesua ikasten.
Azaleko irudian agertzen den bezala.
1. Hartu txipak kolpeekin:
Urrats honetan, ostia zati txikitan zatitu da, film urdin edo UV film bati itsatsi. Txipak jaso behar direnean, pinak behetik luzatzen dira, txiparen atzealdearen kontra astiro-astiro bultzatuz, pixka bat altxatuz. Aldi berean, hutseko toberak zehaztasunez jasotzen du txipa goitik, eta horrela txipa film urdinetik edo UV filmetik ateratzen du.
2. Txiparen orientazioa:
Txipa hutseko toberak jaso ondoren, Lotura Burura pasatzen da, eta eskualdaketan, txiparen orientazioa aldatzen da, kolpeak dituen aldea beherantz begira egon dadin, substratuarekin lerrokatzeko prest.
3. Txiparen lerrokatzea:
Biratutako txiparen kolpeak zehatz-mehatz lerrokatuta daude ontzi-substratuko kuxinekin. Lerrokatze-zehaztasuna funtsezkoa da kolpe bakoitza substratuko padaren posizioarekin zehaztasunez lerrokatzen dela ziurtatzeko. Flux substratuko kuxinetan aplikatzen da, eta soldadura-bolen gainazaleko tentsioa garbitzeko, murrizteko eta soldadura-fluxua sustatzeko balio du.
4. Txirbilaren lotura:
Lerrokatu ondoren, txipa astiro-astiro jartzen du Bonding Buruak substratuaren gainean, eta ondoren presioa, tenperatura eta ultrasoinu-bibrazioa aplikatzen ditu, soldadura-bolak substratuan finkatzea eragiten du, baina hasierako lotura hori ez da sendoa.
5. Birfluxua:
Reflow soldadura-prozesuaren tenperatura altuak soldadura-bolak urtu eta isurtzen ditu, txiparen kolpeen eta substratuaren kuxinen artean kontaktu fisiko estuagoa sortuz. Reflow soldadurarako tenperatura-profila aurreberotze, bustitze, berrefluxu eta hozte faseek osatzen dute. Tenperatura jaisten den heinean, soldadura-bola urtuak berriro solidotzen dira, soldadura-bolen eta substratu-kusken arteko lotura nabarmen sendotuz.
6. Garbiketa:
Reflow-soldadura amaitu ondoren, hondar-fluxua egongo da txiparen eta substratuaren gainazaletan itsatsita. Hori dela eta, garbiketa-agente espezifiko bat behar da fluxu-hondarra kentzeko.
7. Betetzea:
Epoxi erretxina edo antzeko materiala txiparen eta substratuaren arteko hutsunean injektatzen da. Epoxi erretxinak, batez ere, buffer gisa jarduten du kolpeen pitzadurak saihesteko, geroko erabileran gehiegizko tentsioaren ondorioz.
8. Moldea:
Kapsularen materiala tenperatura egokian ondu ondoren, moldaketa-prozesua egiten da, eta ondoren fidagarritasun-probak eta beste ikuskapen batzuk egiten dira, txirbil-kapsulazio-prozesu osoa osatuz.
Hori da SMT teknikan flip chip-ari buruzko informazio guztia. Gehiago ikasi nahi baduzu, hartu eskaera gurekin.

 Euskal
Euskal English
English Español
Español Português
Português русский
русский français
français 日本語
日本語 Deutsch
Deutsch Tiếng Việt
Tiếng Việt Italiano
Italiano Nederlands
Nederlands ไทย
ไทย Polski
Polski 한국어
한국어 Svenska
Svenska magyar
magyar Malay
Malay বাংলা
বাংলা Dansk
Dansk Suomi
Suomi हिन्दी
हिन्दी Pilipino
Pilipino Türk
Türk Gaeilge
Gaeilge عربى
عربى Indonesia
Indonesia norsk
norsk اردو
اردو čeština
čeština Ελληνικά
Ελληνικά Українська
Українська Javanese
Javanese فارسی
فارسی தமிழ்
தமிழ் తెలుగు
తెలుగు नेपाली
नेपाली Burmese
Burmese български
български ລາວ
ລາວ Latine
Latine Қазақ
Қазақ Azərbaycan
Azərbaycan slovenský
slovenský Македонски
Македонски Lietuvos
Lietuvos Eesti Keel
Eesti Keel Română
Română Slovenski
Slovenski मराठी
मराठी Српски
Српски 简体中文
简体中文 Esperanto
Esperanto Afrikaans
Afrikaans Català
Català עִברִית
עִברִית Cymraeg
Cymraeg Galego
Galego 繁体中文
繁体中文 Latvietis
Latvietis icelandic
icelandic יידיש
יידיש Беларус
Беларус Hrvatski
Hrvatski Kreyòl ayisyen
Kreyòl ayisyen Shqiptar
Shqiptar Malti
Malti lugha ya Kiswahili
lugha ya Kiswahili አማርኛ
አማርኛ Bosanski
Bosanski Frysk
Frysk ជនជាតិខ្មែរ
ជនជាតិខ្មែរ ქართული
ქართული ગુજરાતી
ગુજરાતી Hausa
Hausa Кыргыз тили
Кыргыз тили ಕನ್ನಡ
ಕನ್ನಡ Corsa
Corsa Kurdî
Kurdî മലയാളം
മലയാളം Maori
Maori Монгол хэл
Монгол хэл Hmong
Hmong IsiXhosa
IsiXhosa Zulu
Zulu Punjabi
Punjabi پښتو
پښتو Chichewa
Chichewa Samoa
Samoa Sesotho
Sesotho සිංහල
සිංහල Gàidhlig
Gàidhlig Cebuano
Cebuano Somali
Somali Точик
Точик O'zbek
O'zbek Hawaiian
Hawaiian سنڌي
سنڌي Shinra
Shinra հայերեն
հայերեն Igbo
Igbo Sundanese
Sundanese Lëtzebuergesch
Lëtzebuergesch Malagasy
Malagasy Yoruba
Yoruba